FIB-SEM双束系统:微纳尺度下的精准制造与分析平台
当传统加工与分析方法在纳米尺度前止步时,聚焦离子束(Focused Ion Beam, FIB)技术应运而生。它将纳米级的离子束加工与高分辨率的扫描电镜(SEM)成像无缝结合,成为半导体、材料科学、生命科学等领域进行微纳操作、失效分析和原型制作的革命性工具。深圳晟安检测引进先进的双束(FIB-SEM)系统,为客户开启微观世界的“精雕细琢”与“明察秋毫”之旅。
一、FIB技术核心:离子束的多元化能力
FIB使用液态金属镓(Ga)离子源,将离子加速并聚焦成纳米尺度的束斑。离子束与样品相互作用时,主要通过物理溅射作用移除材料,同时也可通过通入反应气体实现选择性增强刻蚀或材料沉积。
1. 高精度离子束切割(Cross-sectioning)
这是FIB在失效分析中最核心的功能。可在指定位置(如芯片上的一个特定晶体管、焊点中的一个空洞)进行纳米精度的切割,暴露出截面,并用内置的SEM实时观察,实现“指哪切哪,切完即看”。
应用:分析芯片内部缺陷、涂层/薄膜界面、焊点IMC层、材料内部裂纹等。
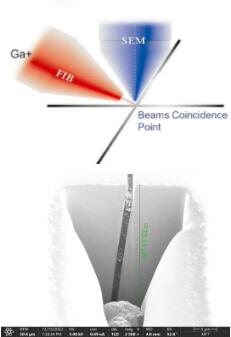
图1:FIB定点切割并利用SEM观察截面
2. 透射电镜(TEM)样品制备
制备厚度小于100 nm的电子透明薄片是TEM分析的前提,也是最具挑战性的步骤。FIB可以高效、精准地完成“挖槽-减薄-抛光”全过程,将目标特征(如晶界、界面、缺陷)保留在薄片中心,成品率高。
应用:为原子尺度的高分辨成像(HRTEM)、衍射分析(SAED)提供高质量样品。
3. 纳米结构与电路编辑
结合气体注入系统(GIS),FIB可实现功能拓展:
- 沉积:通入含铂、钨、碳等前驱体气体,离子束诱导局部沉积导电或绝缘材料,用于修补电路、制作探针pad或保护层。
- 增强刻蚀:通入碘、氯等气体,选择性增强对特定材料(如SiO2)的刻蚀速率,用于修改电路或制备复杂三维结构。
二、双束协同的成像与分析优势
FIB-SEM系统中,离子束与电子束同轴或呈一定角度对准同一点,优势互补:
1. 多样化成像模式
- 高分辨SEM成像:利用电子束获得样品表面高分辨形貌信息。
- 离子束成像:利用离子束成像,对某些材料(如多晶金属)的晶界衬度极佳,提供互补信息。
- 扫描透射成像(STEM):在FIB制备的TEM薄片上,利用透射电子成像,可观察内部结构,分辨率极高。
2. 集成化成分分析
双束系统通常集成能谱仪(EDS)。无论是样品表面、FIB切割的截面,还是制备的TEM薄片,均可进行点、线、面扫描的成分分析,实现形貌与成分的精确对应。
三、典型应用场景
| 应用领域 | 具体应用 |
|---|---|
| 集成电路失效分析 | 定点切割分析开路/短路缺陷、接触孔/通孔异常、介质层击穿、ESD损伤等。 |
| 先进制程与材料研发 | 剖面分析FinFET、GAA等三维结构;观察新材料界面反应、微观组织。 |
| 元器件及焊接可靠性 | 分析BGA/CSP焊点界面IMC、Kirkendall空洞、裂纹;LED芯片电极分析。 |
| 原型制作与电路修改 | 切割冗余线路,沉积新连线,用于芯片设计验证、故障修复。 |
| 科研与前沿分析 | 制备原子探针(APT)针尖样品、微纳力学测试样品、生物样品切片等。 |
四、深圳晟安检测的服务承诺
我们深知FIB分析对精度和经验的要求极高。我们的技术团队不仅精通设备操作,更理解各类材料的特性和客户的分析需求。无论是复杂的芯片失效分析,还是精密的TEM制样,我们都将以严谨的态度和专业的技能,为您提供可靠的第三方检测数据与深度分析报告,助您在微纳世界中精准导航。
温馨提示:FIB擅长处理10μm深度以内的切割,对于更深或大体积的去除,建议结合激光切割或机械研磨。样品通常要求为固体、非强磁性,且目标特征在表面可见或可通过其他手段定位。