FIB技术:揭秘ITO表面缺陷的纳米级诊断利器
在显示器件、触摸屏等高端制造领域,氧化铟锡(ITO)薄膜的性能至关重要。然而,其表面出现的微小缺陷,如腐蚀、污染等,往往会导致产品功能异常。如何在不破坏周边结构的前提下,对这些微纳尺度的缺陷进行精确定位与深度剖析?聚焦离子束(Focused Ion Beam, FIB)技术为此提供了完美的解决方案。
什么是聚焦离子束(FIB)技术?
聚焦离子束(FIB)是一种集微纳加工与实时成像于一体的尖端分析技术。它利用液态金属离子源(通常为镓离子)产生的离子束,经电磁透镜聚焦成纳米尺度的探针。通过精确控制离子束在样品表面的扫描路径,可以实现材料的定点切割、刻蚀、沉积以及高分辨率成像。
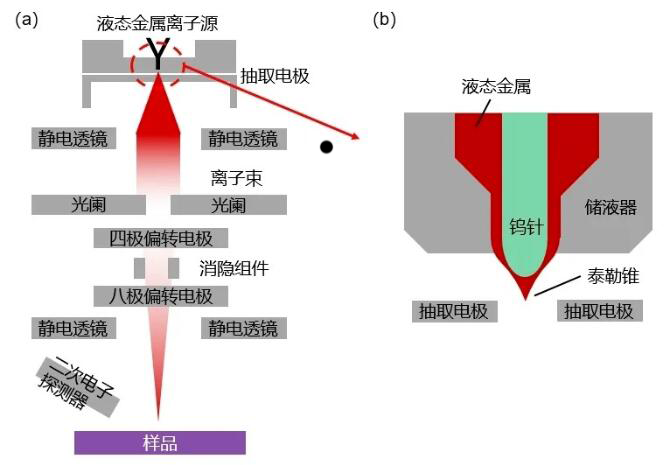
在失效分析中,FIB的核心功能之一是离子束切割。高能镓离子轰击样品表面,通过物理溅射作用逐层去除特定位置的原子,从而暴露出目标截面的内部结构。与此同时,集成在同一系统中的扫描电子显微镜(SEM)可以利用电子束对新鲜切割面进行同步高分辨率成像,实现“边切边看”。

案例详解:FIB在ITO表面腐蚀失效分析中的应用
1. 案例背景
某显示屏产品在前端IC位置的ITO线路出现显示异常。初步观察显示该区域存在疑似腐蚀缺陷,需查明失效原因。
2. 精准定位与截面制备
深圳晟安检测工程师利用FIB-SEM双束系统的优势,首先在SEM模式下精确导航至失效点。随后,启动FIB离子束,在缺陷区域进行高精度定位切割,制备出包含缺陷和正常区域的横截面。
3. 成分分析与根源追溯
在获得清晰的截面形貌后,进一步使用能谱仪(EDS)对失效位置和正常位置进行微区成分分析,对比元素差异。
4. 分析结论
通过对比分析发现,失效位置的ITO层结构已被破坏,并检测到正常区域不存在的Mg、K、Ca等元素。综合推断,失效根源可能是ITO表面在制造或使用过程中受到了含有碱金属盐类的污染。在环境湿度影响下,污染物形成导电离子溶液,在通电工作时引发了电化学腐蚀,最终导致ITO线路失效、显示异常。
深圳晟安检测FIB失效分析服务优势
本案展示了FIB技术在材料微观失效分析中的强大能力。深圳晟安检测凭借先进的FIB-SEM双束系统及专业的技术团队,为客户提供精准、高效的失效分析解决方案:
- 纳米级精确定位:无需大面积破坏,直接对微米甚至纳米尺度的缺陷进行定点分析。
- 原位截面与成像:切割、观察一站式完成,真实反映缺陷的截面形貌与三维信息。
- 多技术联用:结合EDS、EBSD等附件,同时获取成分、结构等多维度信息。
- 广泛应用:服务范围涵盖半导体芯片、金属材料、陶瓷、薄膜涂层等领域的失效分析、成分分析与可靠性测试。
面对产品质量的微观挑战,选择专业的分析伙伴至关重要。深圳晟安检测,致力于以精密的分析技术,守护您的产品可靠性。